XRS-FP2 是一个用于 X 射线荧光(XRF)的定量分析软件包。它会处理使用 Amptek 探测器和信号处理器测量的原始 X 射线频谱,以获得 (1) 元素峰强度(即对应于每个元素的峰强度),以及 (2) 元素浓度或膜厚度。

图 2.该图显示了 XRF 分析中的数据流。
在设置和校准系统并测量光谱后,XRF 分析主要分为三大步骤:
- 解析探测器响应以恢复入射光峰。此步骤校正了逃逸峰、和峰、连续本底、背景峰等。此步骤的输出是一个经过处理的频谱,理想情况下仅显示入射光峰。
- 对光峰进行卷积,以确定探测器中相互作用的 X 射线的强度。此步骤的输出是一个包含每个待分析光峰的强度表。
- 考虑衰减和基体效应,以确定样品中元素的浓度。此步骤的输出是一个浓度表,这是分析的最终结果。
频谱处理会针对逃逸峰、和峰、连续本底、康普顿反向散射和其他效应对谱图进行校正。它还可校正铍窗口和探测器死层中的衰减以及探测器效率。它可以使用理论模型或测得的响应来拟合峰,并且可以执行线性或非线性光谱反褶积。多种处理选项使软件适合各种探测器/光谱仪和应用。
定量分析根据强度计算元素浓度或膜厚度,可以不使用任何标样,也可以使用标样来校准分析参数。通过无标样分析,所有参数都基于理论方程、基本参数数据库以及探测器、X 射线管和几何形状的精确建模。当使用单个分析条件时,无标样模式可用于简单的块状或薄膜厚度已知的单层薄膜样品。当使用标样或多个条件进行分析时,基本参数基于系统对每种元素的测量响应。最准确的分析结果可通过使用成分与待测材料相似的“类型”标样获得。测得的“散射比”可用于估计无法由 XRF 量化的低 Z 材料样品的比例。
XRS-FP2 是一个可执行这三大步骤的功能齐全的分析软件包。该软件包含大量变量,用户可以调整这些变量以匹配实验条件并优化处理结果。

图 3.XRS-FP2 主显示窗口。
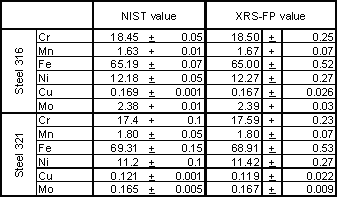
表 1.使用 XRS-FP2 在两种不锈钢合金上获得的结果。这些是 NIST 的“标准参考材料”。这些数据使用 Amptek 的 XR-100-SDD 探测器和 PX5 信号处理器、Mini-X X 射线管和 MP1 安装板采集得来。
高级描述
无论是否使用基本参数(FP)方法,XRF 分析都只有两个步骤。第一步是根据一个或多个标样校准每个元素的响应函数(称为“校准”步骤)。第二步是使用先前存储的校准系数和用于定义样品的 FP 算法(即层数以及哪些元素位于哪些层中)对给定材料进行样品分析。
软件支持多达 55 种元素的单层或块状成分和厚度分析,并以元素和/或化合物形式表示它们。 使用 XRS-FP2 MTF 选项,可同时分析并计算多达 8 层的层间成分和膜厚度。 使用 XRF 技术,每次分析允许使用多达 8 个激发“条件”。每种条件描述了一次单独的分析,它可通过任意组合实验条件(如 kV、靶材、滤光片、探测器滤光片、环境(空气、真空、He)和采集时间)进行自由定义。这使分析员能够以一种条件测量某些元素,而其他元素则完全不同,每次分析都应根据特定元素或一组元素进行优化。同样,谱图处理步骤也可以自由定义,并且都是条件代码设置的一部分。
FP 分析软件支持单个或多个标样校准方案,或者如果射线管、探测器、环境和几何参数已知,则支持完全无标样分析。一次应通过一个校准标样,校准标样信息的合并由内部处理。在每个校准步骤之后,将返回一组校准系数和每个定义元素的相关信息,如果仅使用一个标样,则可以立即使用这些信息。当使用多个校准标样时,所有系数将合并为一组,然后才可以使用这组最终系数进行后续定量分析。
对于无标样分析,必须固定层厚度。结果可以归一化为任何值,并且必须归一化才能进行无标样分析或计算层厚度。元素(或化合物)可以通过差值计算、固定或确定。元素还可以根据化合物公式通过化学计量法来确定。成分结果可以以 wt% 或 ppm 为单位进行计算,对于薄膜,质量厚度使用 µg/cm2 和 mg/cm2 等作为单位。如果密度已知,后者可转换为厚度(微米、微英寸、纳米等)。密度可以输入,理论上也可以计算得出。
所有适当的 FP 计算都在校准和定量过程中使用谢尔曼方程进行。直接荧光计算所需的射线管频谱可由用户提供,也可通过内置模型(Ebel、Pella 等)进行计算。这些射线管频谱可与实验传递函数进行卷积,以推导通过光学器件(如多毛细管束)的预期射线管频谱。根据源路径和探测器路径的输入几何参数还可计算是否存在空气路径。单元素滤光片可插在射线管和样品之间,也可插在样品和探测器之间,软件可同时处理这两种情况。
探测器参数(窗口、厚度、面积等)将用于计算 X 射线穿过窗口并沉积在探测器材料中时的各种吸收和效率效应。这仅在执行无标样分析时才有必要,但计算始终以这种方式进行,以确保一致性和使比较元素之间的校准系数变得更加容易。理论上,所有校准系数都将具有相同的值。在实践中,尤其是与未充分补偿探测器效率的系数相比,差异应尽可能地小。通常在校准使用相同谱线系(例如 K)的元素时,系数变化较小(< 30%),但在从混合线(如 K 和 L)校准时,系数变化通常较大,因为很难进行包含谱线系信息(如荧光产额)的绝对计算。
FP 分析无需采集纯元素频谱,因为元素强度不需要直接比值。它所采用的计算方法使无标样分析更容易地进行。当然,如果需要,可以使用纯元素标样,并且可以在不使用任何“类型”标样的情况下完成完整的 FP 校准。如果分析人员没有现成的类型标样,这将非常有用。
FP 计算考虑了直接和次级荧光效应。FP 数据库中包含用于计算或调用吸收系数、荧光产额、跃迁因子、Coster-Kronig 跃迁、谱线能量、谱线比、跃迁概率等的所有参数。
该软件包含一个用于提供用户界面的主程序窗口。它在至少具有 256MB 内存的标准 PC(Windows XP 和更高版本)上运行。XRS-FP2 软件与 Amptek DPPMCA 显示和采集软件完全兼容,并与该软件集成在一起。它还可以直接控制所有 Amptek 电子器件,并提供自动/重复/连续工作模式。
”